
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Išsamus lustų gamybos proceso paaiškinimas (1/2): nuo plokštelės iki pakavimo ir testavimo
2024-09-18
Kiekvieno puslaidininkinio gaminio gamybai reikia šimtų procesų, o visas gamybos procesas yra padalintas į aštuonis etapus:vaflių apdorojimas - oksidacija - fotolitografija - ofortas - plonos plėvelės nusodinimas - tarpusavio sujungimas - testavimas - pakuotės.
![]()
1 veiksmas:Vaflių apdorojimas
Visi puslaidininkių procesai prasideda nuo smėlio grūdelio! Kadangi smėlyje esantis silicis yra žaliava, reikalinga plokštelėms gaminti. Vafliai yra apvalūs griežinėliai, supjaustyti iš monokristalinių cilindrų, pagamintų iš silicio (Si) arba galio arsenido (GaAs). Didelio grynumo silicio medžiagoms išgauti reikalingas silicio smėlis – speciali medžiaga, kurioje silicio dioksido kiekis yra iki 95%, kuris kartu yra ir pagrindinė vaflių gamybos žaliava. Vaflių apdorojimas – tai minėtų plokštelių gamybos procesas.
Luitų liejimas
Pirmiausia smėlį reikia pakaitinti, kad jame būtų atskirtas anglies monoksidas ir silicis, ir procesas kartojamas tol, kol gaunamas itin aukšto grynumo elektroninės klasės silicis (EG-Si). Didelio grynumo silicis išsilydo į skystį, o paskui sukietėja į vientisą kristalinę formą, vadinamą „luitais“, o tai yra pirmasis puslaidininkių gamybos žingsnis.
Silicio luitų (silicio stulpų) gamybos tikslumas yra labai aukštas, pasiekiantis nanometrų lygį, o plačiai naudojamas gamybos būdas yra Czochralski metodas.
Luitų pjovimas
Atlikus ankstesnį veiksmą, deimantiniu pjūklu reikia nupjauti du luito galus ir supjaustyti plonais tam tikro storio griežinėliais. Luito gabalo skersmuo lemia plokštelės dydį. Didesnes ir plonesnes plokšteles galima suskirstyti į naudingesnius vienetus, o tai padeda sumažinti gamybos sąnaudas. Nupjovus silicio luitą, ant griežinėlių reikia pridėti „plokščio ploto“ arba „įlenkimo“ žymes, kad būtų lengviau nustatyti apdorojimo kryptį kaip standartą tolesniuose etapuose.
Vaflinio paviršiaus poliravimas
Pjaustymo būdu gauti griežinėliai vadinami „plikomis plokštelėmis“, tai yra, neapdorotomis „neapdorotomis plokštelėmis“. Pliko plokštelės paviršius yra nelygus ir grandinės raštas negali būti atspausdintas tiesiai ant jo. Todėl pirmiausia reikia pašalinti paviršiaus defektus šlifavimo ir cheminio ėsdinimo procesais, tada poliruoti, kad susidarytų lygus paviršius, o tada valant pašalinti likučius, kad būtų gauta baigta vaflė švariu paviršiumi.
2 žingsnis: oksidacija
Oksidacijos proceso vaidmuo yra suformuoti apsauginę plėvelę ant plokštelės paviršiaus. Jis apsaugo plokštelę nuo cheminių priemaišų, neleidžia nuotėkio srovei patekti į grandinę, neleidžia difuzijai implantuojant jonus ir neleidžia plokštelei slysti ėsdinant.
Pirmasis oksidacijos proceso žingsnis yra nešvarumų ir teršalų pašalinimas. Norint pašalinti organines medžiagas, metalo priemaišas ir išgarinti likusį vandenį, reikia atlikti keturis veiksmus. Išvalius plokštelę galima patalpinti į aukštos temperatūros aplinką nuo 800 iki 1200 laipsnių Celsijaus, o deguonies ar garų srautu ant plokštelės paviršiaus susidaro silicio dioksido (t.y. „oksido“) sluoksnis. Deguonis difunduoja per oksido sluoksnį ir reaguoja su siliciu, sudarydamas įvairaus storio oksido sluoksnį, o jo storį galima išmatuoti pasibaigus oksidacijai.

Sausoji oksidacija ir šlapioji oksidacija Priklausomai nuo skirtingų oksidacijos reakcijoje esančių oksidantų, terminės oksidacijos procesą galima suskirstyti į sausą oksidaciją ir šlapią oksidaciją. Pirmasis naudoja gryną deguonį, kad susidarytų silicio dioksido sluoksnis, kuris yra lėtas, bet oksido sluoksnis yra plonas ir tankus. Pastarajam reikia ir deguonies, ir labai tirpių vandens garų, kuriems būdingas greitas augimo tempas, bet gana storas apsauginis sluoksnis, kurio tankis mažas.
Be oksidatoriaus, yra ir kitų kintamųjų, turinčių įtakos silicio dioksido sluoksnio storiui. Pirma, plokštelės struktūra, jos paviršiaus defektai ir vidinė dopingo koncentracija turės įtakos oksido sluoksnio susidarymo greičiui. Be to, kuo didesnis oksidacijos įrangos sukuriamas slėgis ir temperatūra, tuo greičiau susidarys oksido sluoksnis. Oksidacijos proceso metu taip pat būtina naudoti manekeno lakštą pagal plokštelės padėtį įrenginyje, kad būtų apsaugota plokštelė ir sumažintas oksidacijos laipsnio skirtumas.
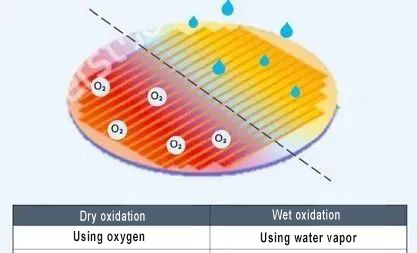
3 žingsnis: fotolitografija
Fotolitografija yra "atspausdinti" grandinės modelį ant plokštelės per šviesą. Galime tai suprasti kaip plokštumos žemėlapio, reikalingo puslaidininkių gamybai, piešimą ant plokštelės paviršiaus. Kuo didesnė grandinės modelio smulkmena, tuo didesnė gatavo lusto integracija, kurią reikia pasiekti naudojant pažangią fotolitografijos technologiją. Konkrečiai, fotolitografija gali būti suskirstyta į tris etapus: dengimo fotorezistas, ekspozicija ir plėtra.
Dengimas
Pirmasis grandinės piešimo ant plokštelės žingsnis yra fotorezisto padengimas ant oksido sluoksnio. Fotorezistas paverčia vaflį „fotopopieriumi“, pakeisdamas jo chemines savybes. Kuo plonesnis fotorezisto sluoksnis ant plokštelės paviršiaus, tuo tolygesnė danga ir smulkesnis raštas gali būti atspausdintas. Šį veiksmą galima atlikti „sukimosi dangos“ metodu. Pagal šviesos (ultravioletinių) reaktyvumo skirtumą fotorezistai gali būti suskirstyti į du tipus: teigiamus ir neigiamus. Pirmieji suirs ir išnyks po šviesos poveikio, palikdami neeksponuotos srities raštą, o antrieji po šviesos poveikio polimerizuosis ir atrodys atviros dalies raštas.
Poveikis
Uždengus fotorezisto plėvelę ant plokštelės, grandinės spausdinimas gali būti baigtas kontroliuojant šviesos ekspoziciją. Šis procesas vadinamas „ekspozicija“. Galime pasirinktinai praleisti šviesą per ekspozicijos įrangą. Kai šviesa praeina per kaukę, kurioje yra grandinės raštas, grandinė gali būti atspausdinta ant plokštelės, padengtos toliau esančia fotorezisto plėvele.
Ekspozicijos proceso metu kuo smulkesnis atspausdintas raštas, tuo daugiau komponentų gali tilpti galutinis lustas, o tai padeda pagerinti gamybos efektyvumą ir sumažinti kiekvieno komponento kainą. Šioje srityje naujoji technologija, kuri šiuo metu sulaukia didelio dėmesio, yra EUV litografija. „Lam Research Group“ kartu su strateginiais partneriais ASML ir imec sukūrė naują sausos plėvelės fotorezisto technologiją. Ši technologija gali labai pagerinti EUV litografijos ekspozicijos proceso produktyvumą ir našumą, pagerindama skiriamąją gebą (pagrindinis veiksnys nustatant grandinės plotį).
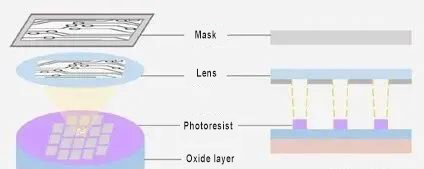
Plėtra
Veiksmas po ekspozicijos yra užpurkšti ryškalą ant plokštelės, tikslas yra pašalinti fotorezistą neuždengtoje rašto srityje, kad būtų galima atskleisti spausdintinės grandinės raštą. Baigus kurti, jį reikia patikrinti įvairia matavimo įranga ir optiniais mikroskopais, kad būtų užtikrinta grandinės schemos kokybė.
4 žingsnis: ėsdinimas
Užbaigus plokštelės grandinės schemos fotolitografiją, naudojamas ėsdinimo procesas, kad pašalintų oksido plėvelės perteklių ir paliekama tik puslaidininkio grandinė. Tam naudojamas skystis, dujos arba plazma, kad būtų pašalintos pasirinktos perteklinės dalys. Yra du pagrindiniai ėsdinimo būdai, atsižvelgiant į naudojamas medžiagas: šlapiasis ėsdinimas naudojant specifinį cheminį tirpalą, chemiškai reaguojant, pašalinant oksido plėvelę, ir sausas ėsdinimas naudojant dujas arba plazmą.
Šlapias ėsdinimas
Šlapias ėsdinimas naudojant cheminius tirpalus oksido plėvelėms pašalinti turi mažos kainos, greito ėsdinimo greičio ir didelio našumo pranašumus. Tačiau šlapias ėsdinimas yra izotropinis, tai yra, jo greitis yra vienodas bet kuria kryptimi. Dėl to kaukė (arba jautri plėvelė) nėra visiškai sulygiuota su išgraviruota oksido plėvele, todėl sunku apdoroti labai smulkias grandinės schemas.

Sausas ofortas
Sausas ėsdinimas gali būti suskirstytas į tris skirtingus tipus. Pirmasis yra cheminis ėsdinimas, kurio metu naudojamos ėsdinimo dujos (daugiausia vandenilio fluoridas). Kaip ir šlapiasis ėsdinimas, šis metodas yra izotropinis, o tai reiškia, kad jis netinka smulkiam ėsdinimui.
Antrasis metodas yra fizinis purškimas, kurio metu naudojami jonai plazmoje, kad paveiktų ir pašalintų perteklinį oksido sluoksnį. Kaip anizotropinio ėsdinimo metodas, purškiamasis ėsdinimas turi skirtingą ėsdinimo greitį horizontalia ir vertikalia kryptimis, todėl jo smulkumas taip pat yra geresnis nei cheminio ėsdinimo. Tačiau šio metodo trūkumas yra tas, kad ėsdinimo greitis yra lėtas, nes jis visiškai priklauso nuo fizinės reakcijos, kurią sukelia jonų susidūrimas.
Paskutinis trečiasis metodas yra reaktyvusis jonų ėsdinimas (RIE). RIE sujungia pirmuosius du metodus, tai yra, naudojant plazmą jonizaciniam fiziniam ėsdinimui, cheminis ėsdinimas atliekamas laisvųjų radikalų, susidarančių po plazmos aktyvavimo, pagalba. Be ėsdinimo greičio, viršijančio pirmuosius du metodus, RIE gali naudoti anizotropines jonų charakteristikas, kad pasiektų didelio tikslumo modelio ėsdinimą.
Šiandien sausas ėsdinimas buvo plačiai naudojamas siekiant pagerinti smulkių puslaidininkinių grandinių išeigą. Labai svarbu išlaikyti visą plokštelių ėsdinimo vienodumą ir padidinti ėsdinimo greitį, o šiuolaikinė pažangiausia sausojo ėsdinimo įranga palaiko pažangiausių logikos ir didesnio našumo atminties lustų gamybą.

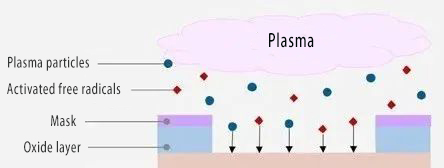
VeTek Semiconductor yra profesionalus Kinijos gamintojasTantalo karbido danga, Silicio karbido danga, Specialus grafitas, Silicio karbido keramikairKita puslaidininkinė keramika. „VeTek Semiconductor“ yra įsipareigojusi teikti pažangius sprendimus įvairiems SiC Wafer gaminiams puslaidininkių pramonei.
Jei jus domina pirmiau minėti produktai, nedvejodami susisiekite su mumis tiesiogiai.
Mob.: +86-180 6922 0752
WhatsAPP: +86 180 6922 0752
paštas: anny@veteksemi.com




